Product : HCE-300
Product Name : HCE-300
A copper etchant that can selectively and uniformly remove copper or copper alloys in fine circuit processes for semiconductors and displays,
while maintaining a fast etch rate and minimizing undercut with a sidewall protection function.
Product Information
| Item | Features |
|---|---|
| Component Type | Hydrogen Peroxide–Acid based |
| Metal Selectivity | Provides selective and uniform etching performance for copper or copper alloys |
| Etching Speed | Maintains fast etch speed, advantageous for forming precise microstructures |
| Surface Roughness | Uniform etching maintains fine and consistent circuit surface roughness |
| Contaminant Removal | Excellent removal of organic/inorganic contaminants such as copper oxide films and resist residues |
Mechanism
Oxidation of the copper surface by hydrogen peroxide
Acid dissolves and removes the oxidized copper layer
Complexing agents stabilize the dissolved copper ions
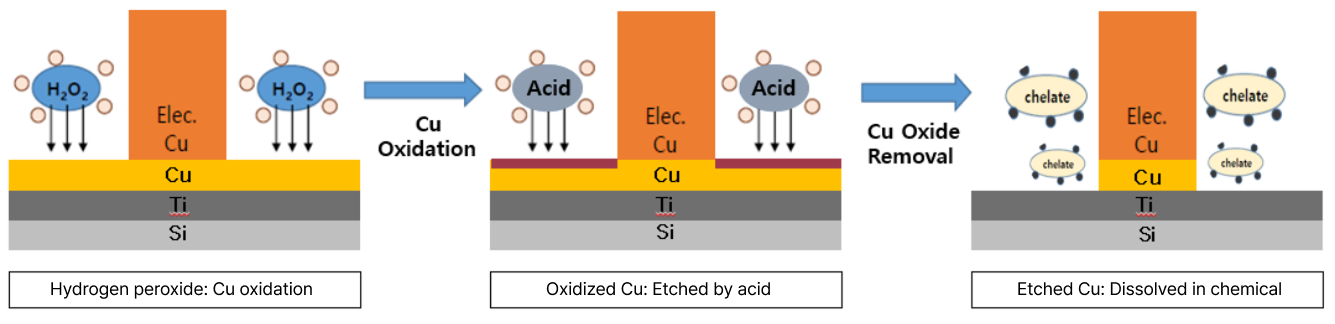
Sputtered Cu Layer Etch Chemical for WLCSP
Thickness Range
(Thk. : 100~500nm)
Eco-friendly (F-free)
Process Applicable
Metal Damage Free
(SnAg, Ni, Au, Al, Ti, Ti-W)
Enables Finer, More Precise
Patterns than Competitors
Excellent
Process Capacity
| Product | Evaluation Item | Plated SnAg Bump | Cu Pillar Bump | WLCSP RDL |
|---|---|---|---|---|
| Competitor | E/R (nm/sec) | 3 | 3 | 3 |
| Undercut (nm) (O/E : 200%) |
327.9 | 772.0 | 373.6 | |
| HCE-300 | E/R (nm/sec) | 4.5 | 4.5 | 4.5 |
| Undercut (nm) (O/E : 200%) |
224.6 (-31.5%) | 373.6 (-51.6%) | 145.3 (-61%) |
| Plated SnAg Bump | Cu Pillar Bump | WLCSP RDL | |
|---|---|---|---|
| Wafer | 
|

|
 |
| Competitor Undercut |
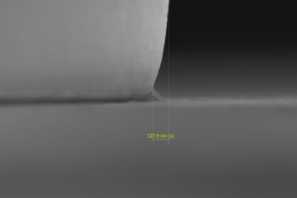 |
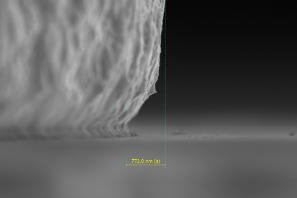 |
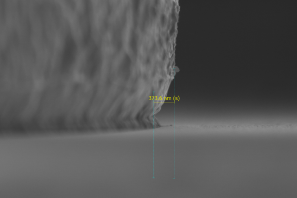 |
| 327.9 nm | 772.0 nm | 373.6 nm | |
| HCE-300 Undercut |

|
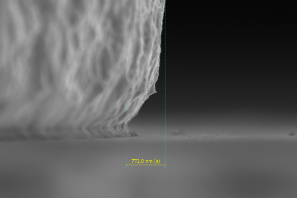
|
 |
| 224.6 nm | 373.6 nm | 145.3 nm |
Comparison of E/R and Undercut by Sample Type

